產(chǎn)品信息 特 長(zhǎng) 薄膜到厚膜的測(cè)量范圍���、UV~NIR光譜分析 高性能的低價(jià)光學(xué)薄膜量測(cè)儀 藉由**反射率光譜分析膜厚 完整繼承FE-3000**機(jī)種90%的強(qiáng)大功能 無(wú)復(fù)雜設(shè)定,操作簡(jiǎn)單��,短時(shí)...

特殊長(zhǎng)度
● 支持從薄膜到厚膜的各種薄膜厚度
● 使用反射光譜分析薄膜厚度
● 實(shí)現(xiàn)非接觸����、非破壞的高精度測(cè)量,同時(shí)體積小��、價(jià)格低
● 簡(jiǎn)單的條件設(shè)置和測(cè)量操作!任何人都可以輕松測(cè)量薄膜厚度
● 通過(guò)峰谷法�、頻率分析法、非線(xiàn)性*小二乘法��、優(yōu)化法等�����,可以進(jìn)行多種膜厚測(cè)量����。
● 非線(xiàn)性*小二乘法薄膜厚度分析算法可以進(jìn)行光學(xué)常數(shù)分析(n:折射率���,k:消光計(jì)數(shù))�。
測(cè)量項(xiàng)目
**反射率測(cè)量
膜厚分析(10層)
光學(xué)常數(shù)分析(n:折射率�,k:消光計(jì)數(shù))
測(cè)量對(duì)象
功能膜�、塑料
透明導(dǎo)電膜(ITO、銀納米線(xiàn))�、相位差膜�����、偏光膜��、AR膜���、PET�、PEN�����、TAC���、PP�、PC、PE�����、PVA��、粘合劑、膠粘劑���、保護(hù)膜����、硬涂層�����、防指紋��, 等等�。
半導(dǎo)體
化合物半導(dǎo)體��、Si、氧化膜���、氮化膜����、Resist���、SiC���、GaAs�、GaN����、InP、InGaAs��、SOI����、藍(lán)寶石等。
表面處理
DLC涂層����、防銹劑��、防霧劑等��。
光學(xué)材料
濾光片、增透膜等����。
FPD
LCD(CF�����、ITO���、LC、PI)��、OLED(有機(jī)膜��、封裝材料)等
其他
HDD��、磁帶���、建筑材料等
測(cè)量原理
大冢電子利用光學(xué)干涉儀和自有的高精度分光光度計(jì),實(shí)現(xiàn)非接觸�����、無(wú)損、高速�����、高精度的薄膜厚度測(cè)量�����。光學(xué)干涉測(cè)量法是一種使用分光光度計(jì)的光學(xué)系統(tǒng)獲得的反射率來(lái)確定光學(xué)膜厚的方法�,如圖 2 所示�。以涂在金屬基板上的薄膜為例,如圖1所示�,從目標(biāo)樣品上方入射的光被薄膜表面(R1)反射�。此外,穿過(guò)薄膜的光在基板(金屬)和薄膜界面(R2)處被反射�����。測(cè)量此時(shí)由于光程差引起的相移所引起的光學(xué)干涉現(xiàn)象����,并根據(jù)得到的反射光譜和折射率計(jì)算膜厚的方法稱(chēng)為光學(xué)干涉法。分析方法有四種:峰谷法����、頻率分析法�、非線(xiàn)性*小二乘法和優(yōu)化法。
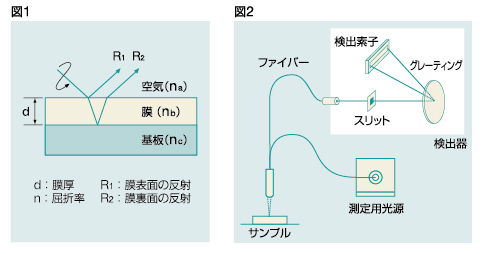
規(guī)格
